 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
图像传感器的性能,不仅依赖于其自身设计和制造工艺,还与封装技术密切相关。
CIS封装非常具有挑战性,封装过程中一旦环境中的微粒掉到传感器表面,都会对最终的成像质量产生不可忽视的影响。格科的COM封装技术(Chip on Module),颠覆了已有的 CSP、COB封装,提升了摄像头模组的光学系统性能、可靠性和适用性。
COM封装的诞生
在COM封装诞生之前,CIS普遍采用CSP封装和COB封装。CSP封装通过在传感器上放置一层玻璃遮挡灰尘,但玻璃也会反射部分光线,导致图像质量下降。COB封装则需在100级无尘室中进行,环境要求极其严苛。
那还有没有其他的解决方案呢?格科技术团队想出来一个方法,直接把金线悬空来做引脚。微观世界很神奇,当金线很短时,变得坚硬而有弹性,可以直接用来做引脚。
在格科浙江嘉善封测基地的100级无尘室中,全自动高精度设备将金线精确地键合在图像传感器上,随后将传感器与滤光片基座贴合,金线另一端悬空成为引脚,随后由摄像头模组厂商将其锡焊至FPCB,装配上镜头与驱动马达等,便形成了完整的摄像头模组。
 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
二焊点悬空金线示意
我们惊喜地发现,COM封装的性能与可靠性完全可以媲美高端的COB封装,甚至更佳。
三大优势,系统级提升
1.增强光学系统性能
COM封装显著提升了摄像头模组的光学系统性能。在COB封装中,芯片直接贴在FPCB上,由于FPCB在生产过程中可能发生形变,导致光轴偏移,进而影响图像质量。
格科COM封装的芯片与镜头均以滤光片基座为基准,改善了FPCB形变引发的光轴偏移问题,极大提升了图像的边缘解析力,特别是在大光圈、高像素的摄像头模组中,这一优势尤为突出。
 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
COM改善光轴偏移示意
相比芯片直接贴装在FPCB的COB封装,COM芯片贴合在滤光片基座上,形成天然的密闭空间,极大隔绝了移动脏污污染芯片感光面。
 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
COM密闭空间结构示意
2.提升模组可靠性与灵活性
在COM封装中,芯片与FPCB之间保持了一定距离,使得摄像头模组能够承受更大的背部压力,提升了模组的可靠性、耐用性。
在COB封装中,直接贴装在FPCB的CIS,对背压更敏感,SFR即图像解析力更易受到影响。COM封装中CIS芯片相对隔离悬空,背压难以直接作用于CIS芯片,因此拥有更佳的图像解析力。
 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
COM背压性能示意
与COB封装方式不同,COM封装通过锡焊连接芯片引脚与焊盘,对FPCB的材料要求降低,进一步提升了FPCB的适应性与灵活性。
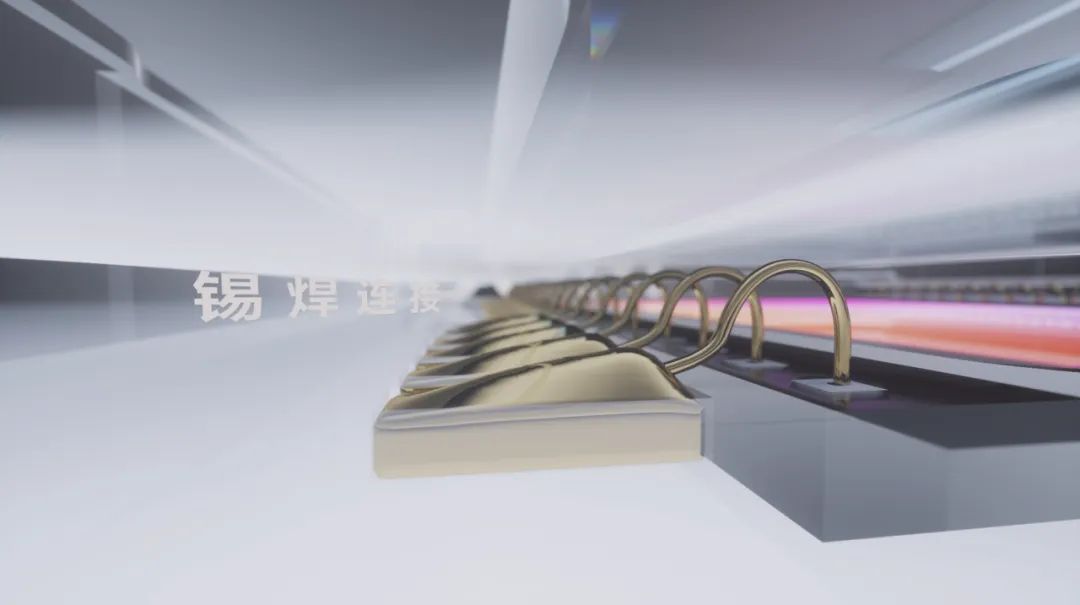 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
COM锡焊示意
3.模组小型化
COM FPCB可以做镂空设计,芯片下沉到FPCB中,相比直接贴附FPCB或补强钢片的COB,可以带来更可控的背压可靠性风险,降低对钢片厚度的要求,因而使整体封装模组的高度更具优势,满足手机对空间的严苛要求,特别是在追求轻薄设计的设备中,这一优势尤为明显。
 ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
ntenteditable="false" style="box-sizing: border-box; vertical-align: middle; border-style: none; margin: 0px; padding: 0px; max-width: 100%;" alt="" />
COM芯片高度优势示意
格科COM封装,既保障了光学系统性能与可靠性,还大幅简化了后续模组厂商的生产工艺,减少了对无尘环境的依赖,从而提升了品质、良率和效率。目前COM芯片已实现量产,随着这一技术的进一步应用,将为更多的终端产品带来更佳的成像表现。





